主要應用
降低導通電阻、超薄化封裝或合封、Flip Chip 厚金屬封裝
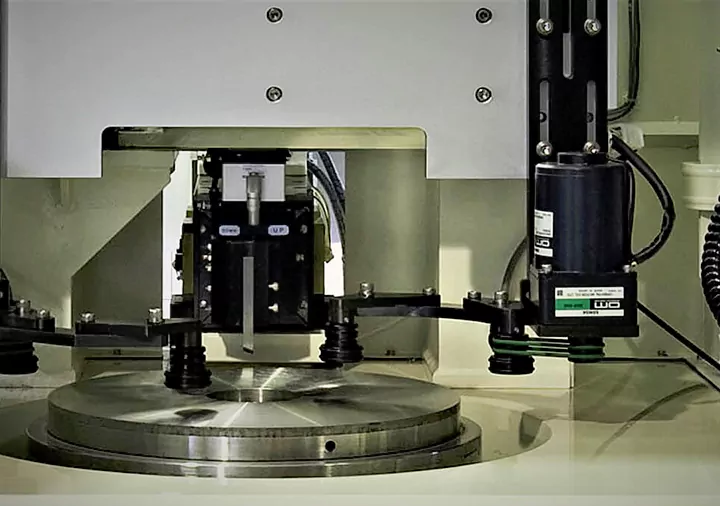
加工服務
6吋、8吋及12吋之P型或N型矽晶圓薄化(一般及Taiko)
6吋及8吋 SiC, GaN晶圓薄化
晶正及晶背之金屬鍍膜、蝕刻
晶圓測試(Chip Probing Test)

我們的優勢
通過高剛性減薄機獲得高質量的「平坦度」「表面粗糙度」和「加工變質層」
⇒降低工序流程和成本
降低背面減薄後薄化時的翹曲。
⇒減薄+拋光的一條龍式加工成為可能。
通過導入SiC專用清洗裝置實現高清凈度
(減少金屬汚染留和顆粒)
在矽晶圓上有量產實績的刀刃防止加工,將來也可以在SiC薄化晶圓上展開。
